
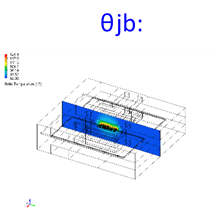
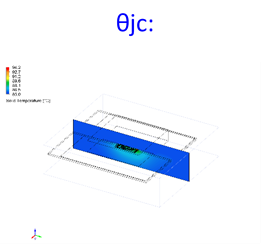
The working temperature of an IC device seriously affects its service performance, reliability, and life time. ChipMOS offers an outstanding thermal characterization service to meet customer requests for thermal measurement and thermal simulation.
Thermal characterization of a semiconductor device is undertaken to determine the circuit junction temperature response while heat is conducted away through the silicon chip package into the ambient.
The thermal simulation software Simcenter Flotherm XT is employed to predict the heat dissipation performance. It is a powerful tool for the optimal thermal design analysis before volume production of a new package.